针对SiC MOSFET和SiC SBD开发的顶部散热封装——TOLT和TSPAK
新闻 | 2025-11-14
关注我们
针对SiC MOSFET和SiC SBD开发的顶部散热封装——TOLT和TSPAK
碳化硅(SiC)MOSFET 和肖特基势垒二极管(SBD)在高功率系统(例如汽车、光伏阵列和数据中心)中的应用,凸显了传统表面贴装封装的局限性。
传统的表面贴装封装采用底部散热(bottom-side cooling),热量需通过电路板传导,这会形成热瓶颈,从而限制先进 SiC 器件的性能发挥,相对较高的结温也会缩短使用寿命。
顶部散热(Top-side cooled, TSC)封装则通过封装顶部直接将热量导向散热器,从而完全绕过印刷电路板(Printed Circuit Board, PCB)。
TOLT 和带引脚的 TSPAK 封装在提升散热性能和降低电磁干扰(EMI)方面具有显著优势。增强的散热能力允许采用尺寸更小、成本更低的 SiC 芯片,在维持相同性能的同时替代传统封装中的大芯片。
1. 什么是顶部散热封装
宽禁带器件技术的进步,尤其是碳化硅(SiC)MOSFET 与肖特基二极管(SBD),带来了严峻的热管理挑战。
虽然这些高速开关器件在效率、功率传输以及功率密度方面相比硅器件具备显著优势,并且具有更高的工作温度范围,但 SiC MOSFET 与 SBD 仍会在极小的芯片面积内集中过多的热量。为降低结温而盲目选择更高性能规格的产品,又会显著提升成本。
传统的表面贴装 SiC 封装依赖底部散热,热量通过 PCB(其导热性较差)传导至散热器。
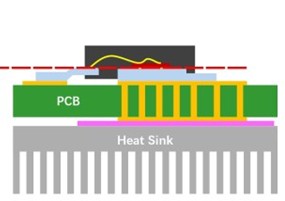
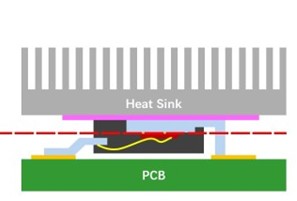
为避免这种热瓶颈及其对性能和可靠性的限制,开发出了顶部散热封装。在此类封装中,热量直接从封装顶部散发至散热器,使 SiC 器件能够在其全部潜能下运行。
瑞能开发的的顶部散热封装包括:
- TOLT(TO-Leaded Top-side cooling package)
- TSPAK(Top-side-cooling surface-mount package)
2. 传统技术

交通电气化的推进,加上风能和太阳能设施输出功率的提升、系统效率的普遍需求提升,以及数据中心等超高功率应用的兴起,推动了宽禁带材料(尤其是碳化硅)的应用转型。
SiC SBD(肖特基二极管)具有极低的正向压降(VF),SiC MOSFET则有极低的导通阻抗(RDS(on))和开关损耗,从而实现高效的功率转换并减少能量损耗。
与传统的通孔安装方式(THD)相比,顶部散热封的主要优势在于高度适配自动化 PCB 组装工艺。
作为表面贴装器件(SMD), TSC 消除了穿孔安装及螺钉固定所需的人工操作,从而降低了成本并提高制造一致性。
传统上,表面贴装封装如 D2PAK(TO-263)、DPAK(TO-252)、TOLL(TO-Leadless)和 DFN(Dual Flat No-Lead) ,都是通过封装底部将热量传导至印刷电路板并扩散,或再传导至散热器。PCB的厚度和材质会引入较高的路径热阻。
3.顶部散热封装
3.1 TOLT
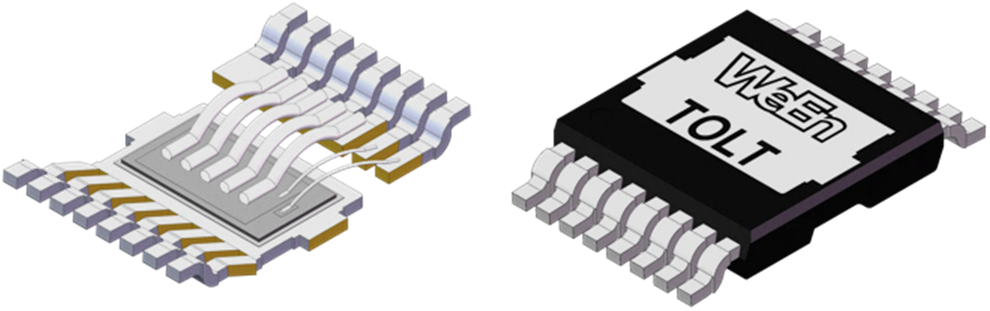
3.1.1 设计结构
TOLT 是一种顶部散热小型化的表面贴装封装,底部焊盘用于焊接至印刷电路板。其顶部设有一块大面积裸露金属板,与芯片热连接,形成一条绕过印刷电路板的高效散热路径。因此,该封装主要用于对热管理有高要求,且布板密度较高的应用场景。
3.1.2 性能与电气特性
该封装提供了一条从半导体结到散热器的直接、低热阻路径,大幅降低结到散热器的热阻(Rth_JH),使器件能在最大额定电流下可靠运行。
TOLT 器件还包含一个 Kelvin 源极引脚(Kelvin Source),以进一步优化栅极驱动性能可降低大电流下的导通阻抗RDS(ON),其小型化的设计还能降低封装的寄生电感,使 SiC 器件可实现超高速开关。电压过冲与振铃因此显著减少,从而获得更干净的开关波形、更低的开关损耗与更低的 EMI。
3.2 TSPAK
![]()

3.2.1 设计结构
TSPAK 是一种带引脚顶部散热表面贴装封装,其电连接通过焊接于 PCB 的鸥翼型(gull-wing)引脚实现。封装顶部的裸露金属板与芯片热连接,可直接紧贴散热器安装。
3.2.2 性能与电气特性
与 TOLT 类似,TSPAK 的顶部散热设计提供出色的热性能,从而能够使用尺寸更小、更具成本效益的 SiC 芯片。与传统设计相比,两种封装均具备低电路寄生电感。TSPAK设计在保持性能的同时优化了成本与机械稳健性,其稍大的壳体设计以及所增加的沿面距离延长槽提供了更长的爬电距离(creepage distance),可以支持更高的系统工作电压。其配置的鸥翼型引脚,为应力释放提供了充分的空间,显著提升PCB功率循环次数。
3.3 顶部散热封装的 EMI 优势
电流环路会产生磁场,环路面积越大,磁场越强,从而提高 EMI 辐射水平。因此,应尽可能使电源与回流路径保持紧密,以最小化高频交流磁场的面积。底部散热封装通常依赖于位于器件正下方的热过孔(thermal vias)来散热,这虽然在热性能上有效,但会阻断地平面的直接回流路径,从而在器件周围形成较大的旁路环路。因此,交流磁场面积无法减小,EMI 噪声显著增加。顶部散热封装则将散热路径完全移出PCB,使电流回路可直接在器件下方闭合,从而显著缩小电流环路面积。
因此,TOLT 与 TSPAK 的高频交变电磁辐射显著降低,整体 EMI 水平大幅减小。
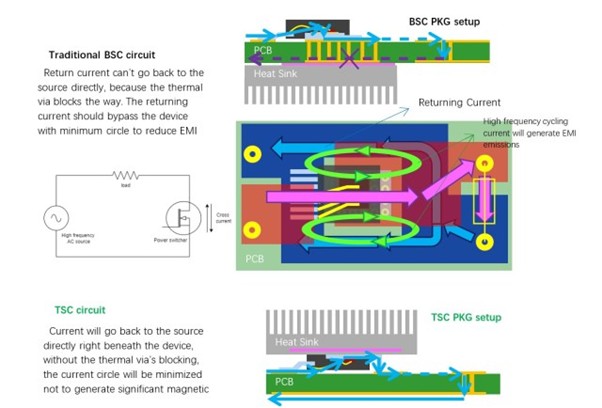
3.4顶部散热封装的成本优势
TOLT和TSPAK封装提供的热性能,使得能够采用更小、更具成本效益的SiC芯片,实现与传统封装中更大、更昂贵的SiC器件相同的性能。

TOLT 和 TSPAK 所提供的卓越热性能,使得可以使用更小、更经济的 SiC 芯片来达到传统封装中更大芯片的性能。
例如,当比较一个 60 mΩ 的 碳化硅D2PAK 器件 与一个在结温 87°C / 环境温度 25°C 下工作的等效 TSPAK 器件时:
- D2PAK 的热阻(R_th j-amp)为 10.4 K/W,功率损耗 P = 5.96 W,可支持电流 9.967 A;
- TSPAK 在相同条件下的热阻降低至 8.8 K/W,功耗上升至 7.045 W,可使用 R_DS(on) 为 70.9 mΩ 的器件。
采用 71 mΩ 的 TSPAK 替代 60 mΩ 的 D2PAK,可实现约 15–20% 的成本节省。
3.5 TSC 封装在 MOSFET 与二极管组合电路中的应用

许多常见拓扑结构都需要 MOSFET 与二极管协同工作,例如:Vienna PFC、升压电路(Booster)、DC-DC 转换器。
这些器件通常需要安装在同一个散热器上以实现高效散热。为简化机械布局与热设计,WeEn 同时供应顶部散热封装的 SiC MOSFET 与SiC SBD,方便工程师在新型高功率密度电源设计中采用。
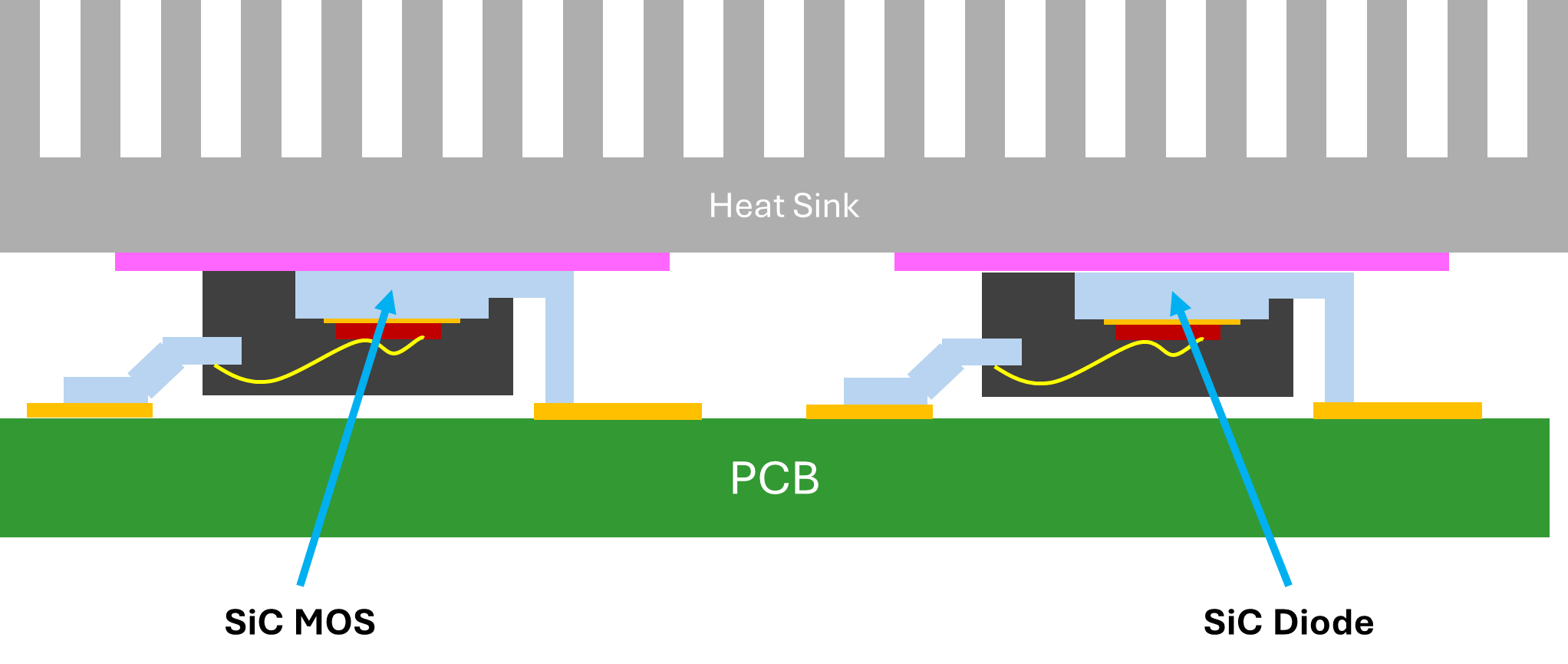
4. 应用领域
4.1 TOLT 封装的应用
TOLT 的卓越散热性能与低电感特性,使其非常适合要求高功率密度与高效率的应用场景:
汽车领域
- 电动汽车牵引逆变器
- 车载充电机(OBC)
- 高压 DC-DC 转换器
- 48V 轻混系统(MHEV)
工业领域
- 光伏逆变器
- 工业电机驱动
- 不间断电源(UPS)
通信与数据中心
- 服务器与 AI 加速器电源
- 5G 基站
电动车充电基础设施
- 公共超级充电桩(40–60kW)
- 家用直流充电桩(7–22kW)
---
4.2 TSPAK 封装的应用
TSPAK 封装以其高功率密度与设计灵活性,尤其适用于汽车与充电领域。
汽车领域
- 车载充电机(OBC)
- 电动压缩机(E-compressor)
- 高压 DC-DC 转换器
- 电动汽车牵引逆变器
工业领域
- 高效太阳能逆变器
- 工业电机驱动
电动车充电基础设施
- 公共超级充电桩(40–60kW)
- 家用直流充电桩(7–22kW)
5. WeEn TOLT 与 TSPAK 产品
WeEn Semiconductors 提供 650V TOLT 封装的 SiC 产品,适用于广泛的工业与汽车应用。其 MOSFET 的导通电阻范围为 20–70 mΩ;其肖特基二极管(SBD)支持 10–20 A 电流。2WeEn 的 TSPAK 封装 SiC 产品涵盖 650V 与 1200V 等级:
- MOSFET 的 R_DS(on) 范围:12–150 mΩ
- SBD 的额定电流范围:10–40 A
6. WeEn 产品线与公告
注:本节用于链接至具体公告与产品页面(例如新品发布、产品规格更新、技术白皮书链接等)







